射頻離子源 RFICP 系列瀏覽數: 4976

KRI 射頻離子源 RFICP 系列
伯東公司美國 KRI 射頻離子源 RFICP 系列, 無需燈絲提供高能量, 低濃度的離子束, 通過柵極控制離子束的能量和方向, 單次工藝時間更長! 射頻源 RFICP 系列提供完整的套裝, 套裝包含離子源本體, 電子供應器, 中和器, 自動控制器等. 射頻離子源適合多層膜的製備, 離子濺鍍鍍膜和離子蝕刻, 有效改善靶材的緻密性, 光透射, 均勻性, 附著力等.
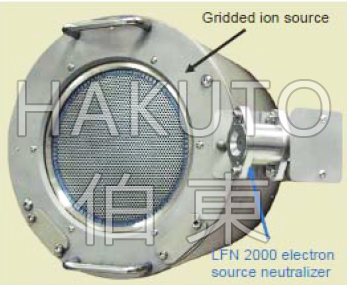
射頻離子源 RFICP 系列技術參數:
|
型號 |
|||||
|
Discharge 陽極 |
RF 射頻 |
RF 射頻 |
RF 射頻 |
RF 射頻 |
RF 射頻 |
|
離子束流 |
>100 mA |
>350 mA |
>600 mA |
>800 mA |
>1500 mA |
|
離子動能 |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
100-1200 V |
|
柵極直徑 |
4 cm Φ |
10 cm Φ |
14 cm Φ |
20 cm Φ |
30 cm Φ |
|
離子束 |
聚焦, 平行, 散射 |
||||
|
流量 |
3-10 sccm |
5-30 sccm |
5-30 sccm |
10-40 sccm |
15-50 sccm |
|
通氣 |
Ar, Kr, Xe, O2, N2, H2, 其他 |
||||
|
典型壓力 |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
< 0.5m Torr |
|
長度 |
12.7 cm |
23.5 cm |
24.6 cm |
30 cm |
39 cm |
|
直徑 |
13.5 cm |
19.1 cm |
24.6 cm |
41 cm |
59 cm |
|
中和器 |
LFN 2000 |
||||
伯東公司 KRI 射頻離子源 RFICP 應用:
離子輔助鍍膜 IBAD ( Ion beam assisted deposition in thermal & e-beam evaporation )
離子清洗 PC (In-situ preclean in sputtering & evaporation )
表面改性, 啟動 SM (Surface modification and activation )
離子蝕刻 IBE (Ion beam etching of surface features in any material)
離子濺鍍 IBSD (Ion beam sputter deposition of single and multilayer structures)

KRi 大口徑射頻離子源 RFICP 220, RFICP 380 成功應用於 12英寸和 8英寸磁記憶體刻蝕機, 8英寸量產型金屬刻蝕機中, 實現 8英寸 IC 製造中的 Al, W 刻蝕工藝, 適用於 IC, 微電子,光電子, MEMS 等領域.

若您需要進一步的瞭解 KRI 射頻離子源, 請參考以下聯絡方式
上海伯東: 葉小姐 臺灣伯東: 王小姐
T: +86-21-5046-3511 ext 107 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 1391-883-7267 (微信同號) M: +886-975-571-910
qq: 2821409400
www.hakuto-vacuum.cn www.hakuto-vacuum.com.tw
現部分品牌誠招合作代理商, 有意向者歡迎聯絡上海伯東 葉小姐 1391-883-7267
伯東公司版權所有, 翻拷必究!
![]() +886-2-8772-8910
+886-2-8772-8910
